光刻胶旋涂的重要性及厚度监测方法
来源:优可测(Atometrics)
发布时间:2025-09-19
随着科技不断发展,芯片制造领域逐渐从微米时代迈向纳米时代,许多高新企业在这微观尺寸中不断追求卓越的技术创新。而目前的主流芯片制造中,光刻工艺是形成精细电路图案的核心技术之一。
光刻图案的形成离不开光刻胶的涂覆,我们可以通过三种方法将光刻胶涂覆在晶圆上,包括旋涂(Spin Coating)、薄膜层压(Film Lamination)和喷涂(Spray Coating),其中应用较多的是旋涂技术。今天,优可测与你一起探索光刻胶旋涂背后的奥秘!
光刻胶旋涂
光刻工艺流程基石
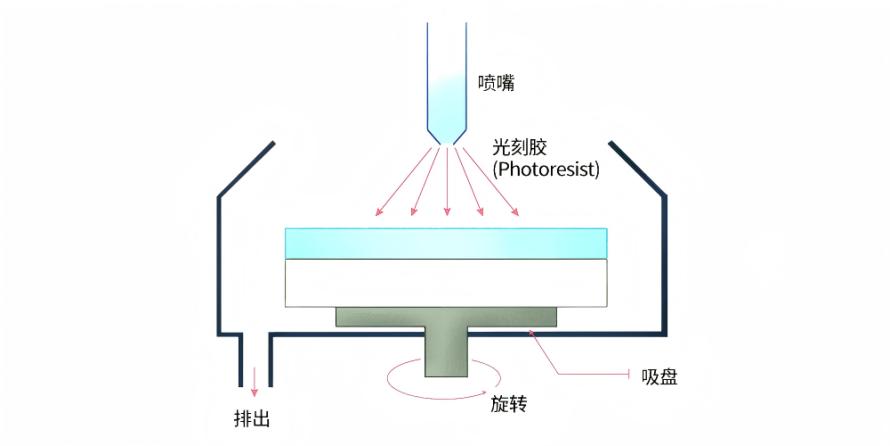
光刻胶旋涂主要是通过旋转衬底的方式涂覆光刻胶,不同的光刻胶有不同的工艺参数要求,比如温度、光刻胶厚度、旋转速度等。
光刻工艺流程主要包括膜底准备→光刻胶旋涂→软烘→对准与曝光 →曝光后烘→显影→坚膜→检测。
光刻胶旋涂处于流程的起始阶段,为后续的曝光等步骤提供了均匀的感光介质,保证曝光区域的感光效果一致。
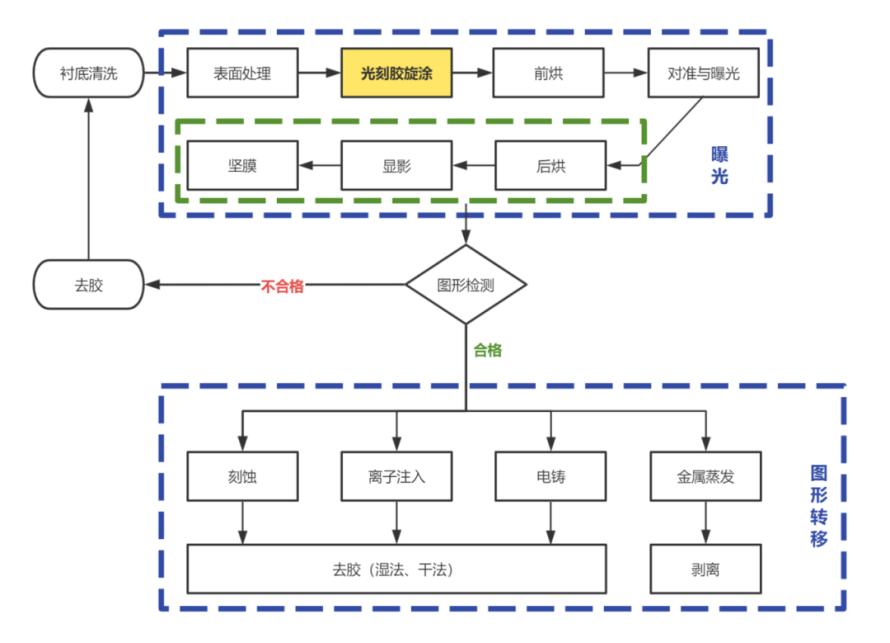
监测旋涂厚度
保障光刻图案精度

有统计数据显示,因光刻胶旋涂不良导致的芯片报废率每降低1%,每年可为芯片制造企业节省数百万美元的成本 。差之毫厘,谬以千里,监测光刻胶旋涂厚度对整个芯片制造流程的质量与效益起着关键作用。
在曝光环节,光刻胶的厚度关联着曝光过程中的光吸收量,依据光学吸收定律,光刻胶的厚度波动会导致光吸收的不均匀性,进而致使曝光后的线条出现变宽、变形等问题。
在刻蚀环节,光刻胶需要承担保护不需要刻蚀区域的责任。厚度过薄,光刻胶难以抵御刻蚀液的侵蚀,导致不该刻蚀的区域被破坏;厚度过厚,则容易残留杂质,同样会影响电路结构。2020 年发表于《半导体技术》期刊的一项研究指出,在刻蚀过程中,光刻胶厚度的均匀性偏差每增加1%,刻蚀后电路图案的线宽偏差会增大3%-5%,这表明了光刻胶厚度对刻蚀精度的重要影响。
光刻胶旋涂的厚度监测
单点测量时间<0.5s
为保障光刻线路图案精度,某半导体客户需要监测产线上的光刻胶厚度,精度要求纳米级,同时需要兼顾测量效率。
针对客户需求,我们采用了优可测薄膜厚度测量仪AF-3000系列,为客户搭建Mapping解决方案:快速分析光刻胶、刻蚀厚度的均一性,提供工艺调整方向。
薄膜厚度测量仪AF系列舍弃传统的LED光源,而是采用了光强均匀、频道稳定的“氘灯”和“钨卤素灯”,支持测单层膜、多层膜、液态膜、气隙层、粗糙/光滑层,最高可测10层膜。一台机器覆盖多台机器的测量范围,测量结果更加精准。

经过实测,AF系列测量精度可达0.1nm,匹配度达0.308420,单点测量时间<0.5s,充分满足客户所需测量精度及效率,成功帮助客户在光刻胶涂覆环节节省光刻胶成本、提升检测效率、提高产品良率!

测量波形图

测量2D结果图

测量3D结果图

测量结果数据表格
资讯热榜 换一批
- 1 全网首拆!深度拆小米YU7四合一域控模块——深度分析英伟达Thor智驾域控
- 2 霍尔、AMR、GMR、TMR的对比解析及技术趋势
- 3 心率血氧传感器全解析:PPG、ECG国产化技术突破及趋势
- 4 深度解析:MEMS红外热电堆阵列的产业格局与未来趋势
- 5 国产MEMS IMU势力崛起:盘点10家核心企业
- 6 欧盟制冷剂法规大变革!如何打好冷媒安全“保卫战”?
- 7 【重磅合作】TRUMPF与荷兰光刻巨头ASML达成独家合作-发布新一代EUV激光器,攻克芯片制造"光源之巅"
- 8 测量精度可达±1mm的雷达液位计测距方案
- 9 【突破通信边界】中国发布全球领先星间激光路由系统,太空互联网迎来"高速时代"
- 10 神眸4MP太空人4G智能相机拆解报告
免责声明
- 1、本文内容版权归属原作者、原发表出处。若版权所有方对本文的引用持有异议,请联系感算商城(service@gansuan.com),我方将及时处理。
- 2、本文的引用仅供读者交流学习使用,不涉及商业目的。
- 3、本文内容仅代表作者观点,感算商城不对内容的准确性、可靠性或完整性提供明示或暗示的保证。读者阅读本文后做出的决定或行为,是基于自主意愿和独立判断做出的,请读者明确相关结果。
- 4、如需转载本方拥有版权的文章,请联系感算商城(service@gansuan.com)注明“转载原因”。未经允许私自转载感算商城将保留追究其法律责任的权利。







