优可测揭秘存储芯片的“品质密码”
来源:优可测(Atometrics)
发布时间:2025-12-01
随着谷歌Gemini3.0、阿里千问等AI大模型的应用爆发与密集迭代,存储芯片作为AI设施最重要的物料之一,其价格涨势持续。全球存储芯片市场正在经历结构性的供需平衡,多家手机厂商已暂缓采购存储芯片,只因上游存储芯片原厂价格持续攀升,报价涨幅接近50%。据预测,存储芯片涨价缺货潮可能会持续到2027年。
在三星、美光、sk海力士等国际大厂轮番提价,国内长江存储、长鑫存储、兆易创新等企业加速突围的产业浪潮中,有“量”的扩张就必然需要“质”的兜底。从晶圆到芯片,从PCB到终端,每一个环节的品质偏差都可能导致产品失效,尤其在AI应用对其稳定性、可靠性要求倍增的当下,精准测量已成为产业链的品质保障之一。
优可测深耕半导体精密检测领域,以多环节高精度测量解决方案,为存储芯片产业的高质量发展路上筑牢品质根基。
晶圆
从源头把控核心品质
晶圆是存储芯片的制造基础,其表面粗糙度、平整度、厚度、涂层厚度、台阶高度等均影响存储芯片的最终品质与性能。对此,优可测实现从光刻胶涂层到晶圆成品的全方位检测:
白光干涉仪AM系列:高精度测量晶圆、光刻胶以及掩模版的表面微观形貌,表面粗糙度测量精度达亚纳米级。
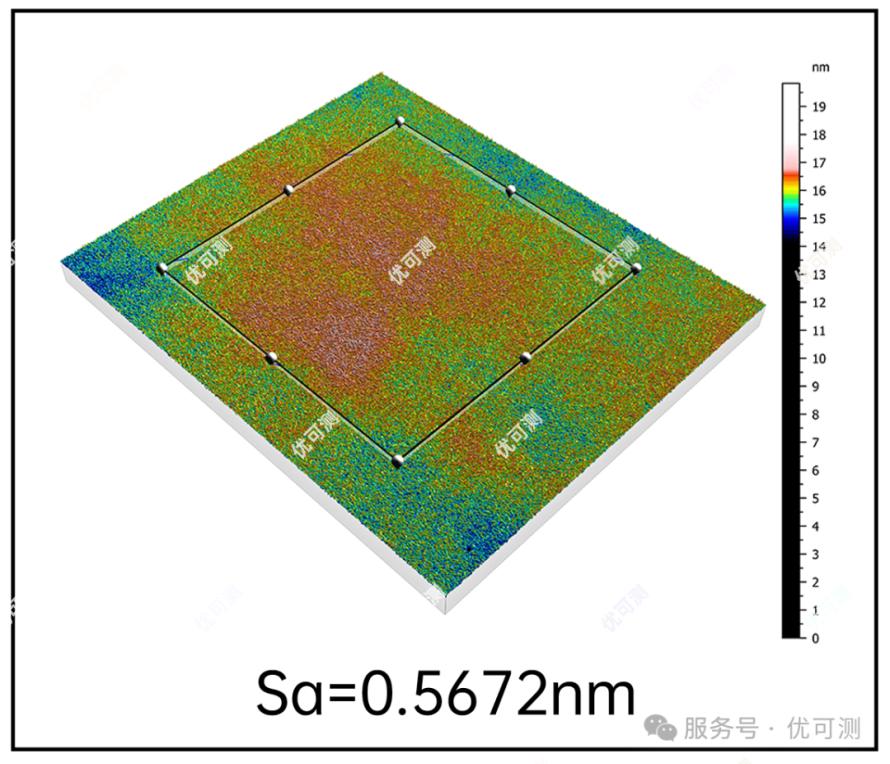
晶圆表面粗糙度测量

晶圆微结构三维形貌测量

掩模板图案高度测量

光刻胶线宽线高测量
薄膜厚度测量仪AF系列:Mapping测量晶圆表面光刻胶涂层厚度,确保曝光、显影环节的工艺一致性,为精细电路成型提供保障。

AF测量过程

测量波形图

测量3D结果

测量2D结果
全自动非接触式厚度测量仪APS系列:一站式实现晶圆厚度、TTV、Bow、Warp等关键厚度参数检测。






晶圆三维量测设备WPM系列:全方位覆盖晶圆Bump、RDL、CD、EBR、PI/PR膜、光刻胶、化合物薄膜、TSV、RST等多维度参数,为晶圆提供全维度测量方案。

芯片封装
提升成品可靠性
封装环节是芯片与外界连接的重要环节,焊点质量、贴装精度直接影响芯片的稳定性。对此,优可测以高精度测量方案,提升芯片成品可靠性:
白光干涉仪AM系列:bump是存储芯片封装和性能实现的核心环节,白光干涉仪可以测量芯片bump的三维形貌,测量高度以及均一性。使存储芯片能够与其他电子元件高效互联,确保数据的输入输出。
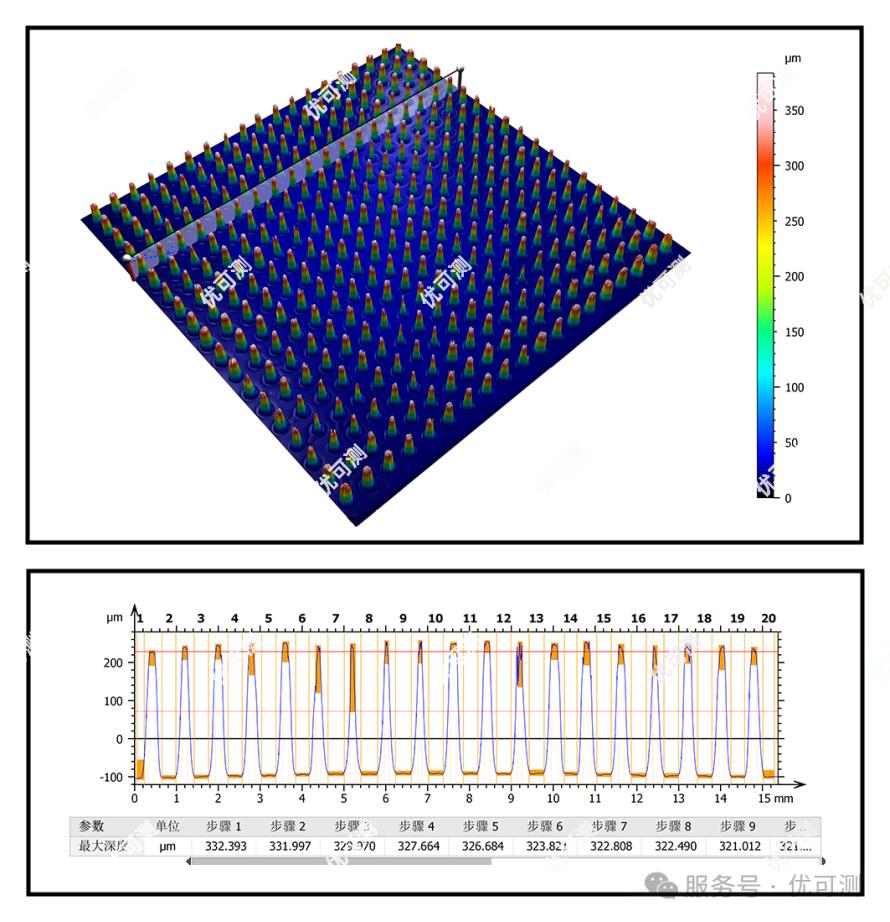
Bump高度测量
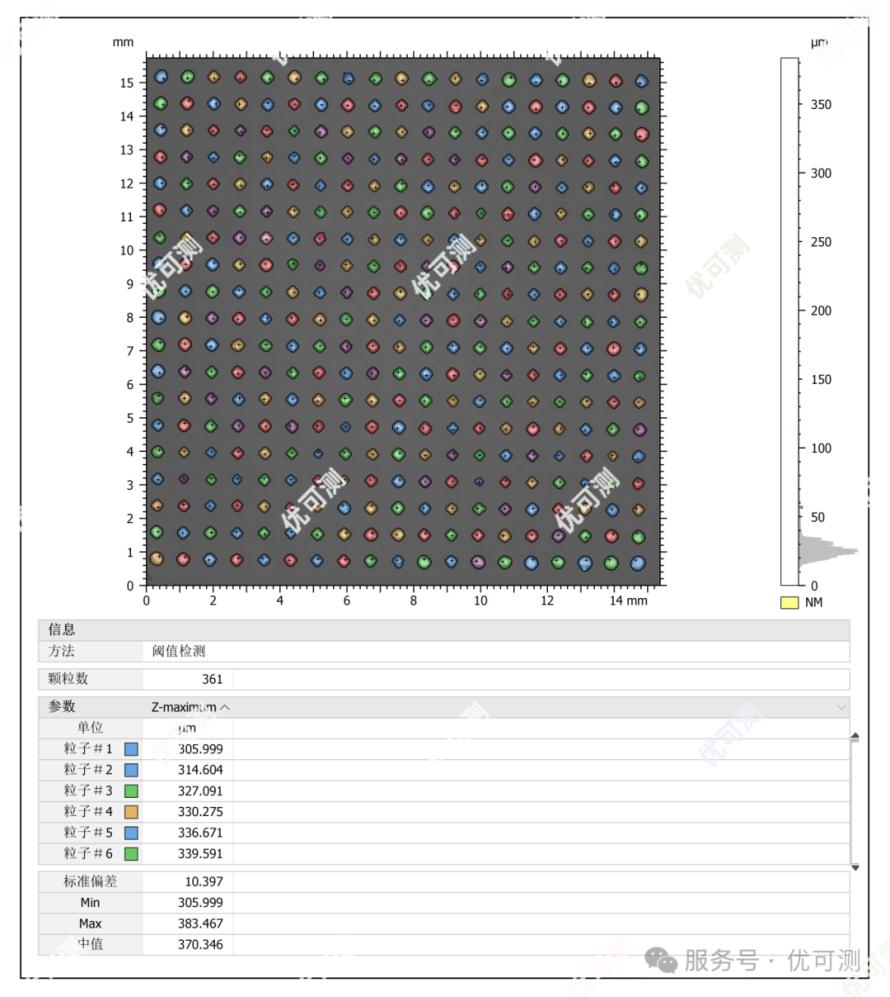
Bump高度均一性
超景深显微镜AH系列:超大景深智能成像和瞬间自动对焦,能够清晰观察芯片结构——BGA焊点有无空洞、虚焊漏焊、引脚等,进行失效分析。

AH观察分析焊点开裂
光谱共焦位移传感器AP系列:在线测量芯片贴装平整度、角针平整度以及BGA锡球高度,确保封装过程中芯片与基板的精准贴合,避免导致后期失效。
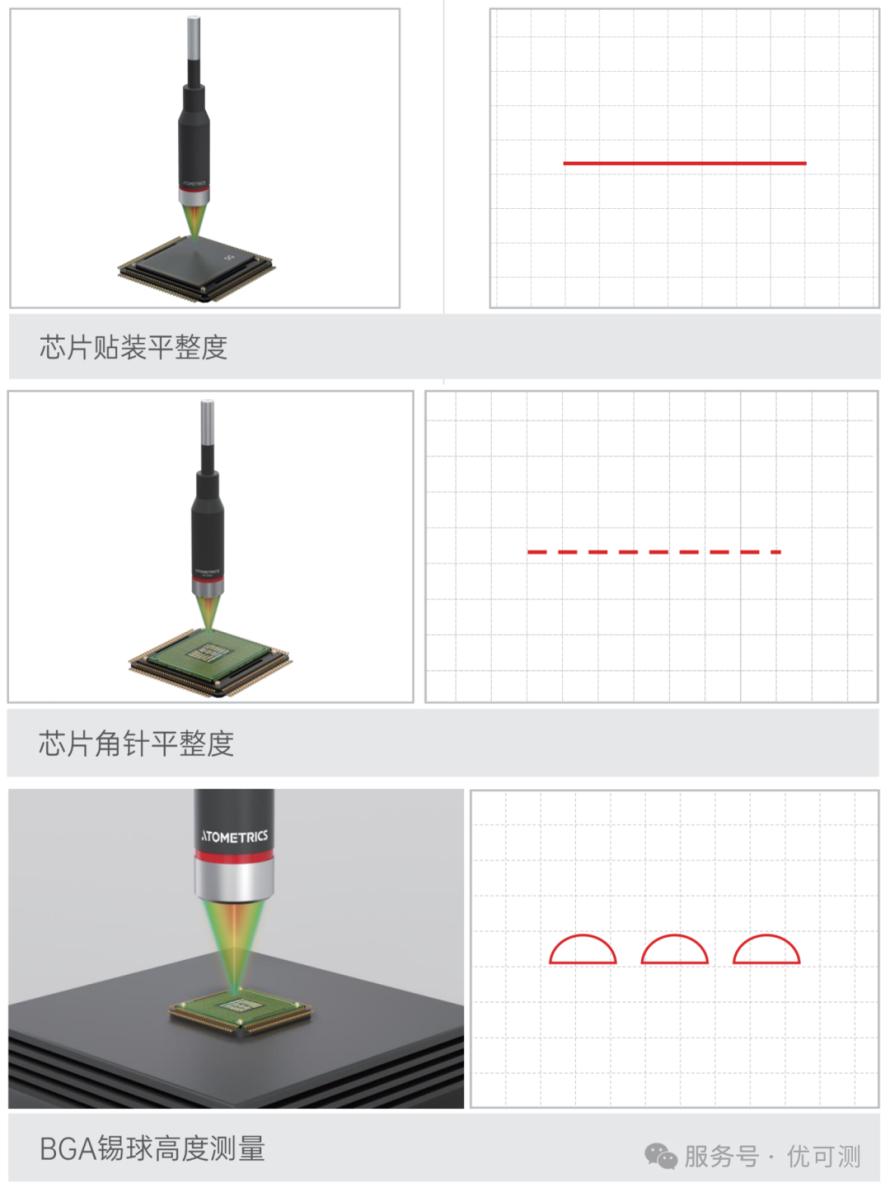
PCB
芯片的承载基石
PCB作为芯片的承载部件,其平面度、镀层粗糙度、电镀后铜厚、线宽线距、盲孔、Pad、Dimple直接影响信号传输。对此,优可测在PCB领域也有着丰富的测量案例:
超景深显微镜AH系列:高像素景深合成,一键完成PCB失效分析。

AH观察PCB失效分析
线激光位移传感器AR系列:快速扫描PCB线路高度,微米级精度测量,保障产品稳定性。

线光谱共焦传感器AS系列:亚微米级测量PCB平面度,聚焦BGA焊接区域,精准测量Pad平面度,保障芯片与PCB的可靠连接。

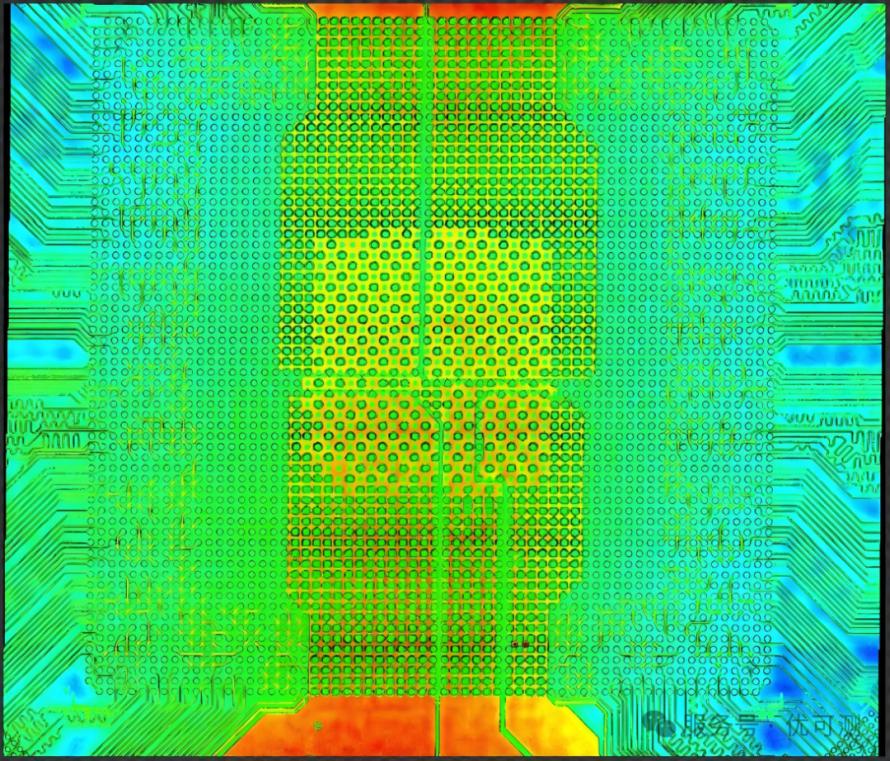
AS扫描3D点云图

AS扫描Pad区域列出ROI
封装基板3D自动量测设备Elite Pro系列:一站式全方位自动检测封装基板的镀层粗糙度、电镀后铜厚、线宽线距、盲孔、Pad、Dimple等关键参数,确保芯片封装品质。
免责声明
- 1、本文内容版权归属原作者、原发表出处。若版权所有方对本文的引用持有异议,请联系感算商城(service@gansuan.com),我方将及时处理。
- 2、本文的引用仅供读者交流学习使用,不涉及商业目的。
- 3、本文内容仅代表作者观点,感算商城不对内容的准确性、可靠性或完整性提供明示或暗示的保证。读者阅读本文后做出的决定或行为,是基于自主意愿和独立判断做出的,请读者明确相关结果。
- 4、如需转载本方拥有版权的文章,请联系感算商城(service@gansuan.com)注明“转载原因”。未经允许私自转载感算商城将保留追究其法律责任的权利。







