
台积电CoPoS封装技术聚焦AI与高性能计算
继CoWoS之后,台积电“以方代圆”的CoPoS封装技术成为市场关注焦点。据业内消息,台积电计划于2026年设立首条CoPoS实验线,地点选在旗下采钰公司,而真正用于大规模生产的量产厂也已确定将建在嘉义AP七,目标是在2028年底至2029年间实现大规模量产。
行业动态
 2025-06-12
2025-06-12

使用封装内霍尔效应电流传感器的太阳能应用场景概要
穿孔式电路板安装霍尔效应电流传感器(比如磁电流传感器)已在太阳能逆变器系统中广泛使用十几年。在相应操作过程中,布线和安装都很方便,无需切断电缆。但是,开环穿孔霍尔效应电流传感器通常无法在使用寿命和温度范围内实现高精度。同时,由于磁芯可能发生脆性损坏,该传感器在安装和运输过程中很容易发生故障,从而降低了系统可靠性。相反,封装内霍尔效应电流传感器具有高精度和低漂移的特性,无论时间、温度如何变化,都能实现精确的电流测量。此外,一体式封装设计还有利于紧凑的设计,不会影响隔离性能,同时会降低系统的复杂性或
电流传感器, 电流传感器模块, 霍尔电流传感器, TMR电流传感器, GMR电流传感器, 磁通门电流传感器, 电流开关, TMCS112x
技术分享
 2025-08-27
2025-08-27

业内首款采用DO-214AB封装、额定浪涌电流为2kA的保护晶闸管
Littelfuse宣布推出Pxxx0S3H SIDACtor®保护晶闸管系列。该系列是业内首款采用DO-214AB(SMC)封装的2kA浪涌保护器件。这一紧凑型解决方案可在防止严重瞬态事件的同时实现产品小型化,成为下一代电源和能源设计的理想选择。
大电流交流配电, 不间断电源设备, 电动汽车壁式充电系统, 电池管理, 工厂自动化电源, 电池充电系统, 工业电源, 工业能耗管理, 工业物联网(IIOT), 工业智能, 工业仪器仪表, 工业自动化, 太阳能/风能, Pxxx0S3H
应用方案
 2025-08-21
2025-08-21

第二代CoolSiC™ MOSFET 1200V Q-DPAK封装分立器件产品扩展
Q-DPAK封装通过简化组装流程并保持卓越的散热性能,帮助客户降低系统成本。与底部散热方案相比,顶部散热器件可实现更优化的PCB布局,从而降低寄生元件和杂散电感的影响,同时提供增强的热管理性能。
CAV, 工业驱动, 固态断路器, 不间断电源UPS, 不间断电源, 电动汽车充电, 光伏逆变器, 光伏/光热, AI机器人, 人工智能AI, AI机器学习
新品介绍
 2025-08-20
2025-08-20

使用封装内霍尔效应电流传感器的太阳能应用场景
封装内霍尔效应电流传感器具有高精度和低漂移的特性,无论时间、温度如何变化,都能实现精确的电流测量。此外,一体式封装设计还有利于紧凑的设计,不会影响隔离性能,同时会降低系统的复杂性或成本。
太阳能, 霍尔效应电流传感器, 磁电流传感器, TMCS112x, TMCS113x
应用方案
 2025-08-12
2025-08-12
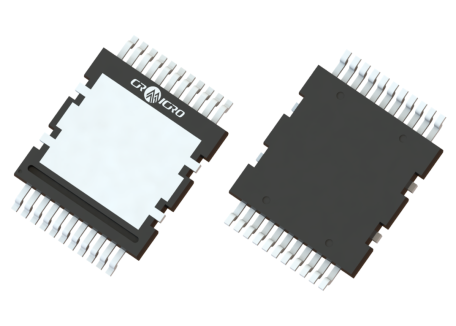
QDPAK&TOLT顶部散热封装,助推华润微SJ&SiC MOS进一步提升终端产品功率密度
随着高端科技的不断发展,现代工业、车业等高端应用领域对功率器件提出了更高功率密度、更低功耗、体积小、散热能力强等严苛的要求。为此,华润微电子功率器件事业群(以下简称PDBG)推出了基于QDPAK&TOLT顶部散热封装的SJ&SiC MOSFET产品,高度匹配OBC、AI服务器电源等高端应用领域需求。
工业自动化, 汽车电子, 通信, AI服务器
新品介绍
 2025-07-01
2025-07-01
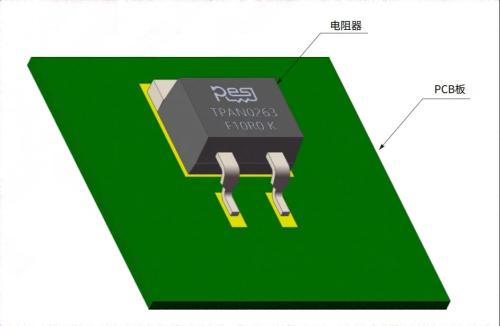
TO封装家族新成员登场
开步睿思RESI自去年五月成功推出TO-220系列平面无感功率电阻器以来,始终关注用户反馈与市场需求,现根据实际应用推出全新尺寸的TPAN0263和TPAL0263系列新一代平面无感功率电阻。
TPAN0263, TPAL0263
新品介绍
 2025-06-25
2025-06-25

开步睿思推出新一代TO220封装平面功率电阻
TO-220封装是一种大功率晶体管、中小规模集成电路、功率电阻器等常采用的一种直插式封装形式。合理加装散热器后,TPAN0220系列电阻器额定功率可达50W,TPAL0220系列电阻器额定功率可达35W。该产品优化了工艺设计,具有优异的长期稳定性、低温度系数、高散热性、低热阻、低电流噪声等特点,使其应用范围非常广泛。本系列产品从原材料,到核心装备,核心工艺,开步睿思均实现了自主可控,质量稳定,交付及时。
汽车电子, TPAN0220, TPAL0220
新品介绍
 2025-06-25
2025-06-25

Allegro 重新定义传感技术,推出全新紧凑型封装电流传感器芯片
近日,Allegro 宣布推出两款全新电流传感器芯片-ACS37030MY 和 ACS37220MZ。凭借 Allegro 的尖端传感技术,这些芯片提供低内部导体电阻、高工作带宽和可靠的性能,适用于各种汽车、工业和消费类应用。
汽车电子, 工业物联网(IIOT), 工业自动化, 消费电子, 消费类电源, 电流传感器, ACS37030MY, ACS37220MZ
新品介绍
 2025-06-19
2025-06-19

MOSFET的30种封装形式
MOSFET自1960年由贝尔实验室发明以来,最初采用金属外壳的TO(Transistor Outline)封装,如TO-3和TO-92。这类封装以铜或铁镍合金为引线框架,通过环氧树脂密封,具备机械强度高、散热性能稳定的特点,能够耐受超过50G的机械冲击。MOSFET封装。
技术分享
 2025-06-19
2025-06-19