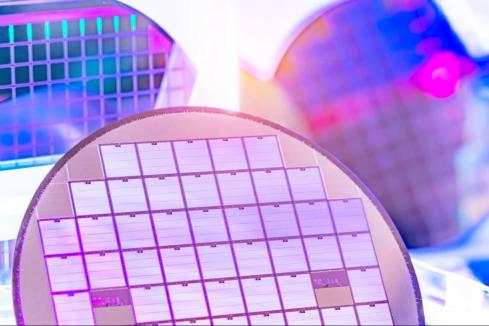
Basler定制视觉方案:聚焦压印后晶圆表面微缺陷检测
在半导体压印工艺中,压印后晶圆表面缺陷检测是保障半导体量产一致性的关键环节。随着器件结构日趋微型化,视觉检测系统需在高速运动场景下完成微米级缺陷的实时捕捉,这对硬件同步性、算法鲁棒性及系统集成度提出了严苛要求。
Basler(巴斯勒)
晶圆, 数码相机
应用方案
 2025-09-19
2025-09-19

半导体万亿市场,怎能容忍“十亿分之一”的疏忽?
安全,从不是某一个节点的守望,而是一场系统性的协同作战。在高精密制造领域,一次微小的气体泄漏,往往源自“环节”之间的断裂。霍尼韦尔以系统性思维,将气体检测方案深度嵌入半导体行业的全生命周期流程,用多场景覆盖与技术联动,真正构建起“一气呵成”的一体化安全防护体系。
Honeywell(霍尼韦尔)
晶圆, 气体传感器, 气体传感器模块, 气体变送器, 气体旋进旋涡流量计, 红外气体传感器方案, 半导体产业, 硅烷站, 化学品库, 特气柜
应用方案
 2025-07-14
2025-07-14

晶圆代工巨变:中国大陆崛起
半导体代工行业正面临复杂的自主或外购决策和国际依赖局面。集成设备制造商 (IDM) 在本地和海外生产半导体,而无晶圆厂公司则严重依赖海外代工厂。这种依赖在美国和欧洲尤为严重,因为这些地区的过剩需求需要大量的海外产能,而这些产能主要由亚洲国家提供。
行业动态
 2025-06-25
2025-06-25

台积电CoPoS封装技术聚焦AI与高性能计算
继CoWoS之后,台积电“以方代圆”的CoPoS封装技术成为市场关注焦点。据业内消息,台积电计划于2026年设立首条CoPoS实验线,地点选在旗下采钰公司,而真正用于大规模生产的量产厂也已确定将建在嘉义AP七,目标是在2028年底至2029年间实现大规模量产。
行业动态
 2025-06-12
2025-06-12

传台积电 2nm 晶圆涨价,4nm也跟着涨
全球半导体代工龙头台积电(TSMC)日前确认将上调 2nm 工艺晶圆价格,涨幅达 10%,这一决定引发行业广泛关注。据多位知情人士透露,台积电计划在未来几周内正式实施调价,其中 2nm 工艺 300mm 晶圆价格将从 3 万美元涨至 3.3 万美元。与此同时,4nm 节点价格涨幅可能高达 10%-30%,成为近年来台积电在先进制程领域最大幅度的价格调整。
行业动态
 2025-05-21
2025-05-21